Optimization of the Solder Ball Array to Minimize Chip Warpage
Application ID: 124581
The ball grid array (BGA) technology is a surface-mount technology widely used in electronic packaging. Usually, there are two types of solder balls considered in the array, including the functional balls that are required for electric connections and the support balls that are used only for reinforcement. In this model, the placement of the support solder balls in the array are optimized to minimize the warpage of the chip during operation.
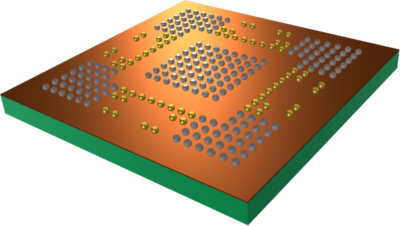
この model の例は, 通常次の製品を使用して構築されるこのタイプのアプリケーションを示しています.
ただし, これを完全に定義およびモデル化するには, 追加の製品が必要になる場合があります. さらに, この例は, 次の製品の組み合わせのコンポーネントを使用して定義およびモデル化することもできます.
アプリケーションのモデリングに必要な COMSOL® 製品の組み合わせは, 境界条件, 材料特性, フィジックスインターフェース, パーツライブラリなど, いくつかの要因によって異なります. 特定の機能が複数の製品に共通している場合もあります. お客様のモデリングニーズに適した製品の組み合わせを決定するために, 製品仕様一覧 を確認し, 無償のトライアルライセンスをご利用ください. COMSOL セールスおよびサポートチームでは, この件に関するご質問にお答えしています.



