Copper Deposition in a Through-Hole Via
Application ID: 97901
This model demonstrates the "butterfly" filling mechanism for copper electrodeposition in a Through-Hole (TH) via exposed to an electrolyte containing halide-suppressor additives.
The Tertiary Current Distribution, Nernst Planck interface in combination with Deformed Geometry is used to track the moving boundary at the cathode surface. The model accounts for adsorption/desorption of additives using dissolving-depositing species formulation.
The model results show selective copper electrodeposition at the middle of the TH, in order to achieve void-free deposition.
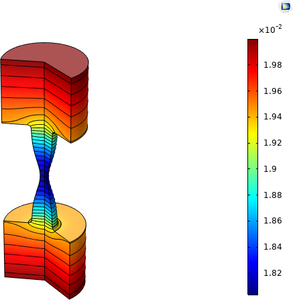
この model の例は, 通常次の製品を使用して構築されるこのタイプのアプリケーションを示しています.
ただし, これを完全に定義およびモデル化するには, 追加の製品が必要になる場合があります. さらに, この例は, 次の製品の組み合わせのコンポーネントを使用して定義およびモデル化することもできます.
- COMSOL Multiphysics® and
- either the バッテリデザインモジュール, 腐食解析モジュール, or 電気めっきモジュール
アプリケーションのモデリングに必要な COMSOL® 製品の組み合わせは, 境界条件, 材料特性, フィジックスインターフェース, パーツライブラリなど, いくつかの要因によって異なります. 特定の機能が複数の製品に共通している場合もあります. お客様のモデリングニーズに適した製品の組み合わせを決定するために, 製品仕様一覧 を確認し, 無償のトライアルライセンスをご利用ください. COMSOL セールスおよびサポートチームでは, この件に関するご質問にお答えしています.



